本文始于2025年6/7月,浅谈应力迁移(EM)失效机制,旨在让读者基本了解 EM 是什么,对设计有哪些影响,以及如何减少这类效应,提高芯片可靠性。
1. 什么是 Electromigration(EM)?
EM,全称:Electromigration,电迁移,是指:在高密度电流作用下,金属线中的金属原子在电流冲击下被“推移”走的现象,最终导致线路出现空洞(void)或堆积(hillock),引发电阻上升、开路或短路失效。
2. 失效机理(Failure Mechanisms)
📝 高密度电子流通过金属时,电子与金属原子发生动量碰撞,电子冲击原子,形成“电子风”(Electron Wind Force);被冲击的原子开始迁移(即从阴极移向阳极)。
📍 在阴极(Cathode)区域:
金属原子不断被“挖走”,会逐渐形成空洞(void),空洞扩大后,截断导电路径 从而引发开路失效(open failure)。
📍 在阳极(Anode)区域:
迁移的原子不断堆积,会形成金属突起(hillock),如果金属持续堆积,可能穿透上层介电层,最后触碰到上/下层导线,最终引发短路失效(short failure)。
最终导致,在阴极端金属线出现黑色空洞缺口,阳极端金属层顶部鼓起为hillock突起。EM 损伤主要集中在 VIA 下方、线宽突变等处。
如下图所示:
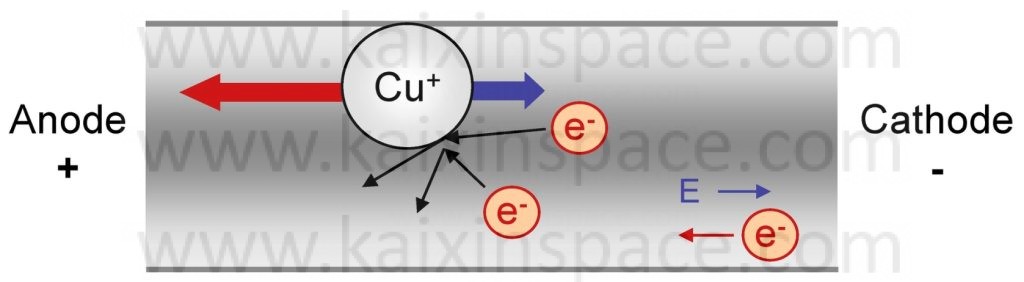

3. 寿命模型(Electromigration Lifetime Model)
常见的寿命模型如下:

| 参数 | 含义 |
|---|---|
| TTF | Time To Failure(失效时间) |
| A | 常数,包含金属横截面积因素 |
| J | 电流密度(A/cm²) |
| n | 电流密度指数 |
| Ea | 激活能,Cu 为 0.9eV |
| k | Boltzmann 常数(8.617×10⁻⁵ eV/K) |
| T | 温度(Kelvin) |
可以,明显看到:
🔸 密度 J 越大 ,电子能量越强,原子迁移越快,寿命越短;
🔸 温度 T 越高,加剧了原子的热运动,同时Joule 热进一步升温,加速了原子扩散过程,导致寿命也越短。
4. 一些EM的防范措施
- 控制线宽/层间电流密度(用工艺手册中提供的Imax 表计算);
- 多个 VIA 结构分流(stacked or redundant vias);
- 合理分配大电流金属走线,减少热点(如功率线、时钟分支);
- 尽量使用上层金属走大电流路径;
- 使用具有高电迁移耐力的材料;
- 仿真验证。
当然,解决芯片中的电迁移问题可能需要多种方法相结合。在为超大规模集成(VLSI)设计互连器件时,仿真软件是帮助您确定能够满足特定电流要求的理想选择。芯片设计人员必须分析流经互连器件的电流密度以及电阻增加的各种原因,以便预测芯片中的电迁移。
5. 参考
【1】电迁移 — 维基百科
【2】tsmc specification document
【3】https://www.ansys.com/zh-cn/blog/what-is-electromigration
